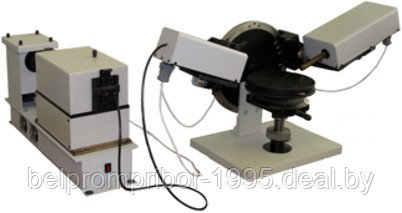
- Основные
- СостояниеНовое
- Вес5 кг
- Страна производительРоссия
Прецизионная диагностика многослойных тонкопленочных структур с субнанометровым разрешением в широком спектральном диапазоне; Высокая точность измерений; Высокая производительность измерений; Измерения толщин тонких пленок, оптических параметров тонкопленочных структур и спектральных зависимостей оптических констант материалов всех типов: металлов, полупроводников, диэлектриков, полимеров, жидкостей и др. (в том числе анизотропных).
Комплекс обеспечивает:
- измерения параметров многослойной структуры (до 6 слоев);
- определение параметров n и k и толщин всех слоев в рабочем спектальном диапазоне;
- автоматический подбор параметров образца для фиттинга измереных спектров.
Комплект поставки:
- Спектральный эллипсометр
- Гониометр с фиксированным изменением угла падения
- Матричная система позиционирования образца
- Предметный столик с подвижками
- Источник излучения
- Оптоволоконный адаптер
- Малогабаритный быстродействующий дифракционный монохроматор
- Персональный компьютер
- 19" LCD монитор
|
Технические параметры |
|
|
Спектральный диапазон, нм |
350 - 1000 нм |
|
Спектральное разрешение |
2,0 нм |
|
Диапазон измеряемых толщин |
до 50000 нм |
|
Погрешность измерения толщин |
0,2 нм |
|
Погрешность измерения коэффициента преломления |
0,005 |
|
Время единичного измерения: |
1мс/точка |
|
Изменение углов падения |
45°-70 ° и 90° |
|
Пределы перемещения предметного столика по двум координатам |
0-25 мм |
|
вертикальное перемещение |
0-20 мм |
|
Диаметр светового пучка |
3 мм |
